はじめに
簡単な結晶構造を持つSiでは、欠陥のない綺麗なエピタキシー層の成長が達成されていて、Siのデバイス構造はこの問題のないエピタキシー成長層に作りつけられています。しかしながら、結晶構造がほんの少しだけ複雑な4H-SiCのエピタキシー層の表面を走査型電子顕微鏡(SEM)で観察するとエピ層成長時に形成された各種エピ欠陥を観察することができます。市販のエピウエハではこれらのエピ欠陥は年ごとに減少傾向ではありますが、残念ながら現在もエピ層表面に存在しています。
4H-SiCのエピ層成長中に顕在化する欠陥の原因を考えると、もともとの4H-SiCの基板に導入されている転位や積層欠陥などの格子欠陥が原因となっているものと、エピ層成長時に新たに何らかのきっかけで導入された欠陥に分類されます。また、形態を考えて分類すると、六方晶の結晶構造を持つ4H-SiCのエピ層成長中に何らかのきっかけで局所的に立方晶の3C-SiCが現れることに起因するものと、格子欠陥や表面ステップのバンチングに起因するエピ層表面の凹凸によるもとに分類することもできます。いずれにしても これらのエピタキシー層中や表面の欠陥は4H-SiCのパワーデバイスの歩留まり低下の原因になっています。これらの欠陥密度を下げることは、4H-SiCのパワーデバイスの歩留まりを向上させるうえで大変重要です。これらの欠陥密度を下げるには、4H-SiC結晶成長技術と4H-SiCエピタキシー層成長技術の粘り強い洗練と推敲を必要としていて時間をかけて少しずつ欠陥密度が低下しています。
ところで、この20年の間に、走査型電子顕微鏡の技術も変化してきました。in-lens検出器(ILD)や、through-lens検出器(TLD)などを装着した走査型電子顕微鏡の登場と進化により、それらの装置技術や利用技術に大きな進歩がありました。これらの新しい検出器を用いると、これまで見ることのできなかった微妙な表面ステップや表面のコントラストが観察され、新しい知見を得ることが可能になりました。図1は例として示すTLDを用いて観察した市販の4H-SiCエピウエハの表面のSEMの高分解能像です。4度オフ基板の表面ステップが観察されています。観察場所は表面ステップの並びに多少の乱れのあるところを示しています。テラスの広い部分と狭い部分の2つのコントラストが観察されています。
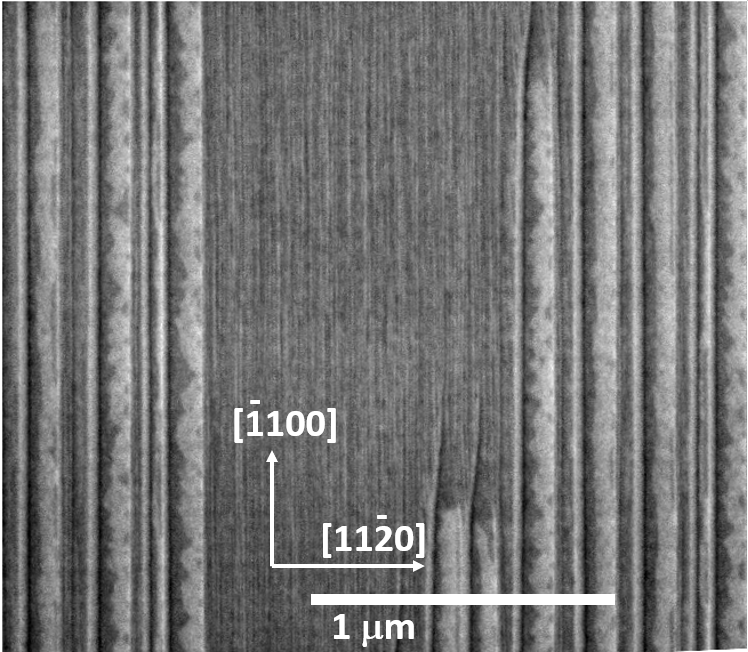
この文章と次回からの一連の4つのコラムの文章では、これらのSEMの新しい検出技術を使って観察される各種のエピ層表面欠陥の像を紹介し簡単な説明を添えます。“その1” では転位や積層欠陥の表面終端部の像について紹介します。
エピタキシー層表面の転位終端部のピットとステップバンチング
市販のエピウエハを購入し表面をSEMで観察すると最も高い頻度で観察されるのはピットとステップバンチングです。図2のSEM像(a)とAFM像(b)は同一場所の観察像です。凹凸の定量的表示はAFMが得意ですが、SEM像の観察では、通常凹凸の定量情報を得ることは現在のところ簡単ではありません。しかしながらSEM像では低倍から高倍までくっきりと観察することができ、観察したい場所を容易に拡大し観察することができ、観察の作業効率が良いと考えられます。図2(a)のAは貫通刃状転位(TED)が表面で終端しているところです。拡大した像を(d)に示します。 図2(a)中のBは貫通らせん転位(TSD)で、拡大すると(c)のような像が観察されます。エピ層表面の転位終端部はピット形状を示します。エピ層成長開始前にウエハ表面をH2でクリーニングを行います。この際に転位終端部はエッチングされ、ピットが形成され、そのピットがエピ層成長に伴い深さと幅が拡大していきます。H2クリーニングの条件、エピ層成長の条件にピットの深さ幅は依存しています。
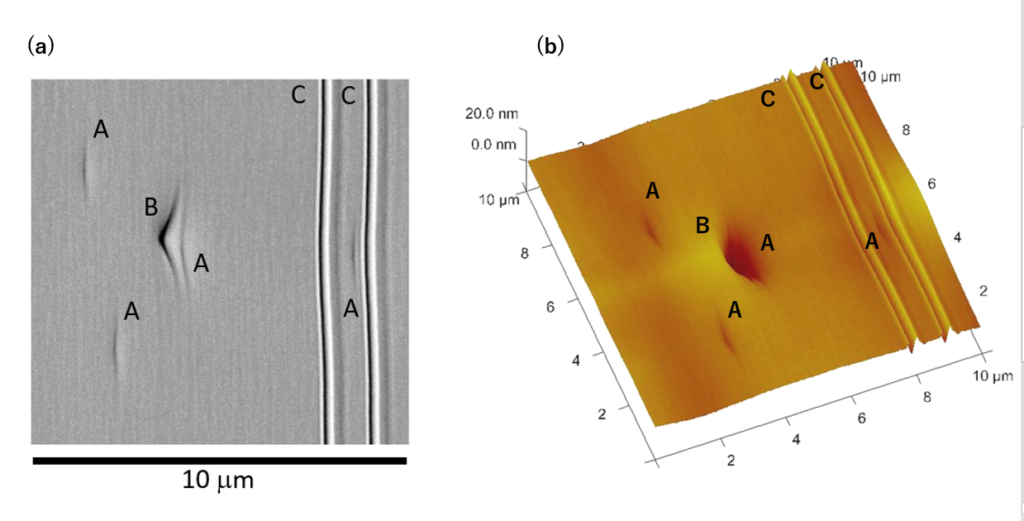
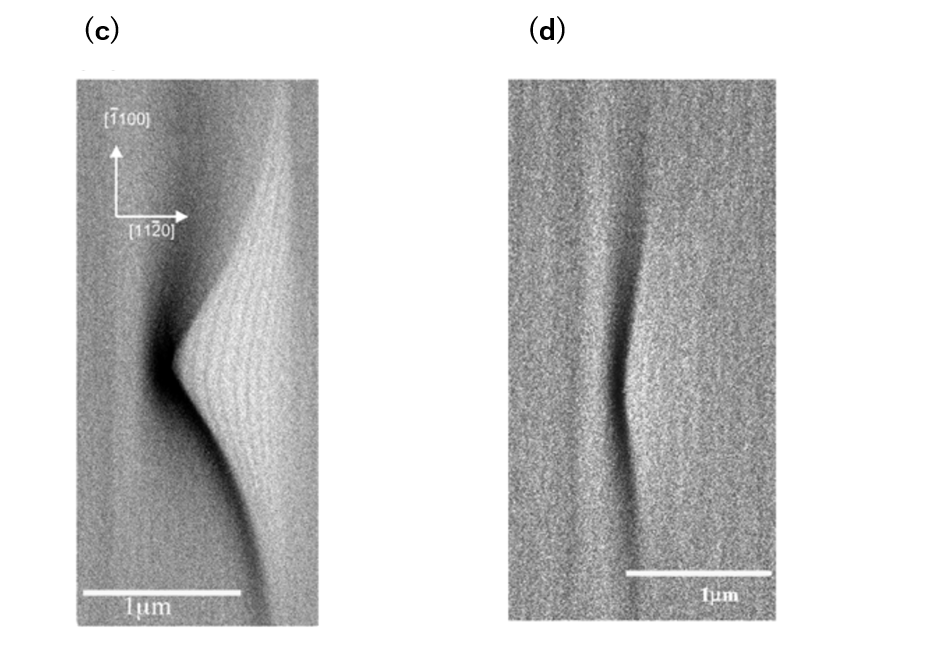
表面に様々なエピ欠陥が出現すると、ステップフローモードで成長しているエピ層の川下側にはステップのバンチングにより溝等が発生します。以前このコラムで紹介したようにこれらの表面の凹凸が存在するところでMOS構造を作成するとSiO2/SiC界面は平坦ではなく凹凸が形成されます。そのことにより電界集中が発生し、MOS構造の絶縁破壊が発生することがあります。これを防ぐには、エピ層成長の前のH2クリーニングプロセスを適切に制御する必要があります。
ショックレー型積層欠陥終端部
ILDやTLDを搭載しているSEMで半導体デバイス構造を察するとpn構造でのドーパントの違いによるコントラストや4H構造部と3C構造部にコントラストの違いが観察されます。ありがたいことに3C構造部は4H構造部より明るいコントラストが観察されます。また、4H-SiCのエピ層表面の積層欠陥終端部をILDやTLDで観察すると積層欠陥が明るいコントラストを示し積層欠陥の終端位置を簡単に見つけることができます。
図3はTLDで観察されたショックレー型積層欠陥の表面終端部とその周囲のステップバンチングを示しています。ABは積層欠陥の表面終端部です。ショックレー型積層欠陥は明るく観察され、この積層欠陥は左側へ行くに従いエピ層の深い部分に連続的に繋がっていて、深い部分はコントラストが薄くなっていることが観察されます。Aはショックレー型部分転位の終端部ですが、この位置から左上に向かってショックレー型部分転位がエピ層奥へ繋がっています。この積層欠陥の終端部はH2エッチングによると考えられる溝のようなものは明瞭には観察されていません。おそらくショックレー型積層欠陥そのものには歪が付随していないため部分転位部以外ではエッチングされていないと推察されます。またこの積層欠陥終端部の周囲では表面にステップバンチングが形成され表面ステップの配置が等間隔ではなくイレギュラーな間隔で並んでいることが観察されています。また表面のテラスのコントラストに明暗の2種類のコントラストが存在することが分かります。
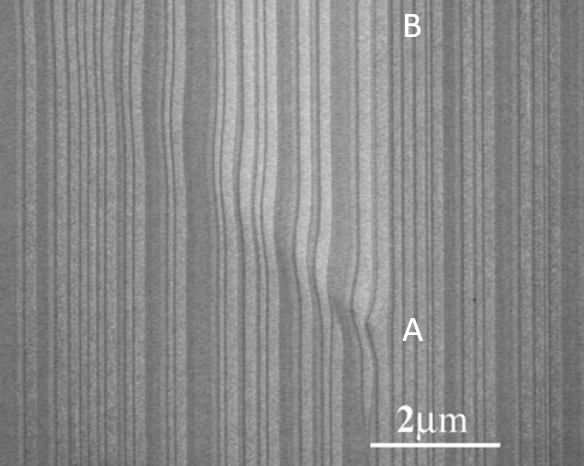
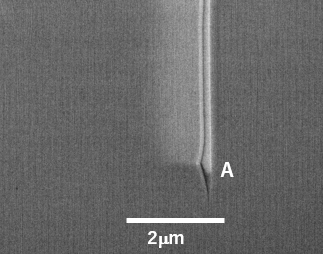
フランク型積層欠陥表面終端部
フランク型積層欠陥の終端部も特徴的な表面構造を示します。図4にフランク型積層欠陥表面終端部を示します。点Aの部分にフランク部分転位が存在しエピ層の深部へ繋がっています。通常、三角形状の特徴的な窪みがフランク部分転位表面終端部では観察されます。これらのフランク型積層欠陥の変位ベクトルはR=1/4<0001>+1/3<1100>だと推察されますが、フランク型積層欠陥には多数枚のショックレー型積層欠陥が付随する例がいくつかの論文で報告されているのでこれらのフランク型積層欠陥も多数枚のショックレー型積層欠陥を伴っているのかもしれません。
これらの転位終端部や積層欠陥終端部での形状はH2エッチングやエピ層の厚みなどによってもが、凹凸の程度や外見に違いがあると考えられています。






