前コラムではGa2O3でpn接合をどう実現するかを見てきた。どうしてもpn接合ができなかったら、Ga2O3パワーデバイスの未来は無いのだろうか。プランBを検討してみる。最初の議論に戻ると、肝要な点は、n型Ga2O3空乏層中のイオン化したドナー(正電荷)から出る電気力線を、漏れ電流を抑えつつ、どこかの位置に置いた負電荷で受け止めることある。pn接合では、p型半導体のイオン化したアクセプターがこの負電荷であり、半導体のバンドギャップが電流のバリアになる。pn接合以外でn型Ga2O3に空乏層を形成できる接合構造がないだろうか、ショットキー接合あるいはMIS接合が考えられる。
逆バイアスされたショットキー接合では、空乏層のドナーから発する電気力線を金属電極の電子が受け止める。電流のバリアはショットキー障壁が担う。ショットキー障壁高さは高々バンドギャップの半分しかないので、漏れ電流がpn接合よりも増えることが避けられない。
絶縁破壊電界が小さいSiのSBDでは、ショットキー接合リーク電流は大きな問題にはならなかった。絶縁破壊電界が大きくショットキー接合に大きな電界がかかるSiCでは、リーク電流の増大が問題となった。実用化されたSiC SBDでは、リーク電流を抑えるためにJBS (Junction Barrier Schottky)構造が採用された。JBS構造は、ショットキー接合とp型層をストライプ状に交互に並べて配置したもので、nドリフト層からの電気力線をpストライプで受け止め、ショットキー接合には過大な電界が加わらないようにしている。
SiCよりも絶縁破壊電界が大きなGa2O3 SBDでもJBSに相当する構造が必須である。p型がないGa2O3では、pストライプの代わりにトレンチを掘り、その側壁に絶縁層を挟んでフィールドプレート電極を設けることが試みられている。逆バイアス時には、トレンチ側面から空乏層が広がり、表面のショットキー接合電界が緩和され、JBS構造と同様の効果が得られる。これは次コラムで議論するMIS接合の応用で、その耐圧はMIS接合の耐圧で決まってくる。
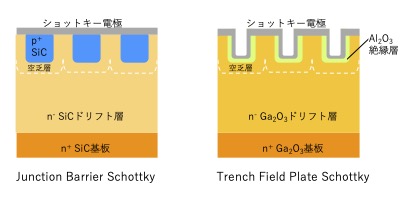







コメントを残す