よく知られているように4H-SiCウエハには転位と呼ばれる線状の格子欠陥をある程度の密度で含んでいます。SiCパワーデバイス研究開始当時はまだSiC結晶中に含まれている転位がパワーデバイスへ及ぼす影響について不明な部分が多くありました。SiCデバイスのさらなる高耐圧化、高信頼性化を進めるにあたり、SiCパワーデバイスに及ぼす転位の影響を明確にすることが、かつて重要な伏線テーマとなっていました。Siの場合、1960年代なかばにはSi単結晶からは転位は消えてしまい無転位の巨大なSi完全結晶よりSiウエハは切り出されていたため、Siでは各種デバイスへの転位の影響については系統的に調べた成果は残されておらず不明な部分が多かったのです。
SiCパワーデバイスの高耐圧化、高信頼性化の研究の過程で、転位がパワーデバイスに及ぼす効果について明確になってきました。この文章では、転位がパワーデバイスに及ぼす影響について過去のプロジェクトで明確になったことがらを簡単にまとめます。これらの経験は、他のワイドバンドギャップ半導体材料でパワーデバイスを開発する際に貴重な参考になるかもしれません。
MOS構造での絶縁破壊
貫通らせん転位や貫通刃状転位などの転位がSiO2/SiC界面に接触しているとMOS構造で絶縁破壊を引き起こすことが報告されています。しかしながらこれらの転位がSiO2/SiC界面に接触していても絶縁破壊が起こらない例も報告されていて、2010年頃まで矛盾する2つの実験結果が並列して発表されていて、どちらが正しいのかよくわからない状態でした。この矛盾する実験結果の違いは、エピ層成長前にH2ガスによる表面クリーニングの行いかたの違いによることが後に明らかになりました。H2クリーニングを長時間行うと転位が表面終端している位置では、エッチングにより深いくぼみが形成されこの状態でエピ層成長を行うと最終的にエピ層表面にある程度の深さの凹凸が形成されます。この状態で表面を熱酸化しSiO2/SiC界面を形成すると界面は平坦ではなく凹凸を伴っています。この状態のMOSキャパシターを動作させると平坦ではないSiO2/SiC界面部では電界集中が発生し、MOS構造は破壊されることが分かりました。一方H2クリーニングを短時間で切り上げると表面の凹凸は浅く、MOS構造形成後も高い絶縁特性を維持することが明らかになりました。またエピ層成長中に形成される各種のエピ欠陥もSiCウエハの表面に凹凸を作りだしMOSキャパシターの歩留まり低下の原因にあることが確認されました。これらの成果は下記の発表にまとめられています。
- T.Suzuki, et al., Mat. Sci, Forum, Vol. 717-720, 477-480 (2012).
- O. Ishiyama et al., Jpn. J. Appl. Phys. Vol. 53, 04EP15-4 (2014).
- H. Sako et al., Jpn. J. Appl. Phys. Vol. 53 051301-3 (2014).
PN接合での逆バイアス時に電流リークを起こすキラー欠陥について
エピ層部にpn接合構造の素子を多量に作製し、作製途中で放射光を用いたX線トポグラフ法でそれぞれのpn接合構造での転位分布を撮影した後、最終的に電極をつけpn接合での逆バイアスでの耐圧試験を行いました。一部の素子では比較的低い電圧で電流リークが発生します。電流リークが発生する素子をエミッション顕微鏡で観察すると、電流リークが発生すると、局部的に特定の位置で発光が観察されます。発光が観察される位置を放射光X線トポグラフ像で確認すると貫通らせん転位の像と一致します。しかしながら、すべての貫通らせん転位で電流リークが発生するのではなく、一部の少数の貫通らせん転位の位置で低い逆バイアス電圧で電流リークの発生が確認されました。これらの電流リークを起こす特定の欠陥をキラー欠陥などと当時呼んでいました。
一見普通の貫通らせん転位のようにトポグラフ像では見えるのですが、このキラー欠陥は、後に収束電子回折法(CBED)を用いた研究により、転位の周りの歪を示すパラメターであるバーガース・ベクトルがb=<0001> +<1100>という巨大な刃状成分を持つ混合転位であることが示されました。また、このような大きなバーガース・ベクトルを持つ転位が存在すること自体も大きな発見でした。
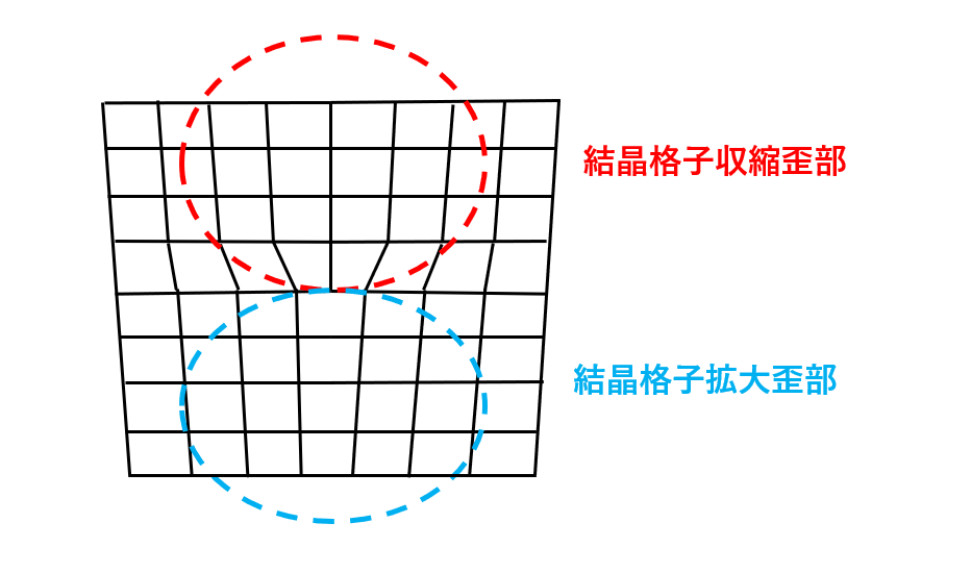
巨大な刃状成分を持つことがこのキラー欠陥の特徴と考えられます。刃状転位の場合、転位の周りでは結晶のユニットセルの体積の膨張や収縮を伴っています。図1に刃状転位の周りの結晶格子の体積の膨張部や収縮部を模式的に示します。ユニットセルの体積の収縮を伴う場所では、原子空孔を誘引しやすいと考えられます。特にイオン注入後のアニール時にある程度の量の空孔を誘引している可能性があると考えられます。またユニットセルの体積の膨張を伴う場所では、不純物金属原子を格子間原子の形や、原子サイズの大きな不純物原子は結晶格子原子と置換されると考えられます。このように、巨大な刃状成分を持つ転位に沿って、空孔濃度、各種の不純物原子濃度が上昇していると考えられます。らせん転位の周りの歪は剪断歪により構成されていて、ユニットセルの体積の膨張や収縮はないと考えられていますので、巨大な刃状成分が問題を引き起こしていると考えられます。濃縮される不純物原子とはドーパントとして加えられる原子の他に、SiCウエハに微量に最初から存在している各種金属不純物原子などが転位線を伝わって拡散していることが推察されます。このキラー欠陥の密度は高くはないのですが、結晶成長中に貫通らせん転位と複数の貫通刃状転位が合体して出現していると考えられ、結晶中の転位密度の低減により減少していくものと考えられます。これらの研究の詳細は下記の文献に示されています。
- T. Tsuji, Mat. Sci. Forum., Vol.645-648 pp913-916 (2010).
- S. Onda et al., Philos. Mag. Lett. Vo. 93, pp439-447 (2013).
- 松畑ら、電気学会論文誌A Vol.135, pp768-779 (2015).






