はじめに
4H-SiC-MOSFETを使ってon-off動作を繰り返していると、on抵抗が次第に増大していく現象が観察されることがあります。この現象は順方向特性劣化現象と呼ばれています。4H-SiC-MOSFETにon-off動作をさせると、off動作の直後にMOSFETのbody-diode構造に順方向の電流が流れます。この時にon抵抗が増大する原因を作り出していることがあります。
図 1-1に4H-SiC-MOSFETの基本的な構造の模式図を示します。ユニポーラーデバイスのMOSFETの構造とバイポーラデバイスのp-i-n構造が重なっています。このp-i-n構造のp層、i層、n+層の部分を赤文字で示します。基本的な4H-SiC-MOSFETでは、n+層部は基板そのもので、基板表面にn–ドリフト層(i層)のエピタキシー層を成長させ、デバイス構造を作っています。on-off動作はMOSFETが担っていますが、off動作時にはp-i-nダイオードとして機能しています。このp-i-n構造のi層部(n–ドリフト層)に基底面転位が存在していると、off動作直後に流れる順方向電流により基底面転位からショックレー型積層欠陥が湧き出してきます。on-off動作の繰り返しにより次第にこの積層欠陥が拡大成長していきます。これによりSiC-MOSFETのon動作時の抵抗が増大しはじめ、特性劣化が進行します。つまりn–ドリフト層(i層)部に基底面転位が存在していると電子と正孔の再結合位置として働き、再結合によって放出されたエネルギーでSiコア30度部分転位が動きショックレー型積層欠陥が拡大することが原因だといわれています。
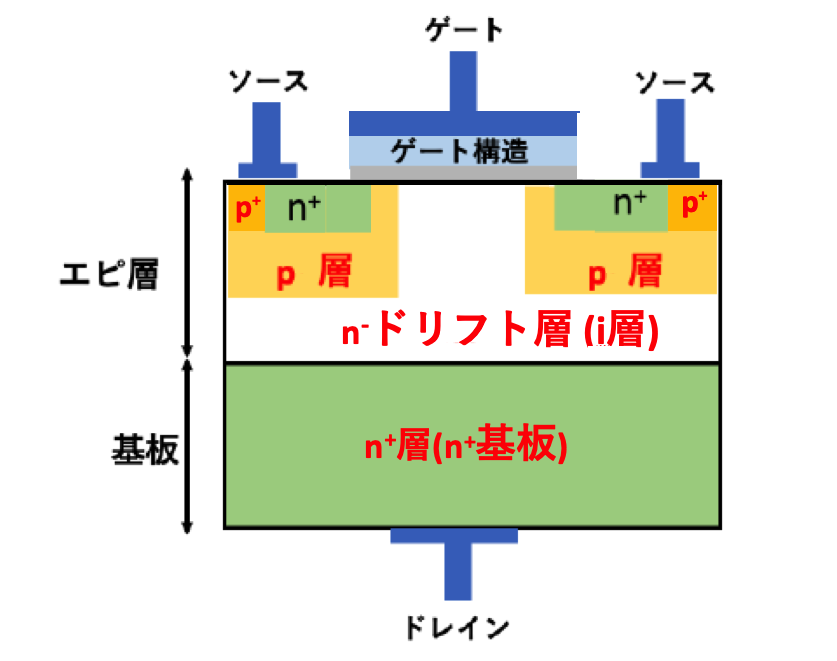
再結合による転位の運動はREDG(Recombination Enhancement Dislocation Glide)効果と呼ばれています。n–ドリフト層(i層)部分にSiコア30度部分転位が存在するとREDG効果で動きます。そして、ショックレー型積層欠陥の面積を増大する方向に動くことも実験的に観察され知られています。 一方Cコア部分転位は動かないことは知られています。Siコア30度部分転位や、Cコア部分転位などの言葉の意味はこの解説で後ほど説明します。REDG効果は光や電子線などの照射でも引き起こされ、REDGはRadiation Enhancement Dislocation Glideの省略形だとも言われることがあります。実際、低ドーパントの4H-SiCウエハに強い光を照射しつつ顕微PL法で観察すると、Siコア30度部分転位が動きショックレー型積層欠陥の面積が増大していくところが観察されます。また、走査型電子顕微鏡(SEM)のEBICモード(electron beam induced currentモード)や透過型電子顕微鏡(TEM)で基底面転位を観察すると、電子線照射によりSiコア30度部分転位が動き積層欠陥が成長するところをin-situで観察することができます。ちなみに、p層部分や、n+層部分では、マイノリティキャリアは動き回る前に再結合するので、基底面転位が存在してもREDG効果は発生しにくいと考えられています。
順方向特性劣化現象を起こしたデバイスの内部を、顕微PL法や、X線トポグラフ法などで観察すると、n–ドリフト層部に多数のショックレー型積層欠陥が増殖し成長していることが観察されます。この現象に対していろいろな対策が、ある程度とられるようになってきています。また、4H-SiC-MOSFETの中には、特性劣化が飽和しても、まだon抵抗は低いので、特性劣化は、おり込み済みで利用されている場合もあるようです。これらのSiC-MOSFETは低電圧用にn–ドリフト層が薄く設計され、n–ドリフト層が薄いので特性劣化が飽和した状態になっても、それほど多数のショックレー型積層欠陥が増殖していないのです。ところが高耐圧用のSiC-MOSFETはn–ドリフト層部が厚く、多数のショックレー型積層欠陥が成長するので、本格的対策が必要になります。
さて、REDG効果によって増殖・成長したショックレー型積層欠陥の形状を観察すると、様々な特徴的な形状のものが観察されます。それらの形状を整理すると、結晶学的なルールに従っていることが理解されます。この連載では、特性劣化の原因となるn–ドリフト層部で増殖成長するショックレー型積層欠陥の形状について、まず考察します。積層欠陥の形状が整理されて理解されると、その形状より発生原因となる基底面転位の素性が推察されます。つまりどういう理由でn–ドリフト層に導入された転位かを推察することが可能です。増殖する積層欠陥の原因となる基底面転位の素性が理解されると、デバイスプロセスの改善に結びつくかもしれません。興味がある方は読んでいただければと思います。この連載は以下の流れで話を進めます。
(a) 最初に、この連載の(1),(2)で、解説を進めるに際して必要な4H-SiCの結晶構造、基底面転位についての知識、基底面転位の分解についての知識を簡単に説明します。これらの事柄は、必要な要点のみを整理します。
(b) REDG効果によりSiコア30度部分転位が動き菱形形状のショックレー型積層欠陥が形成されることは実験的にはよく知られています。連載の(3)と(4)で、積層欠陥の菱形形状の向きと、発生源となる基底面転位との幾何学的な関係を考察します。この目的のため六角形状の転位ループを描いて、転位ループのどの部分にSiコア30度部分転位が現れるのかを整理します。そして、どのように菱形積層欠陥が成長するのかを整理します。
(c) 実際の観察では、2重菱形積層欠陥が現れたり、1重菱形積層欠陥が現れたり、積層欠陥が現れなかったりします。このような積層欠陥の現れ方を整理するために八角形の基底面転位ループを描いて、基底面転位の向きと積層欠陥の現れ方を考察し、どの基底面転位がどの結晶方位を向くとどのような菱形積層欠陥が現れるのかを、この連載の (5)で整理します。
(d) 順方向特性劣化はMOSFETのn–ドリフト層に基底面転位が存在すると発生するわけですが、n–ドリフト層部分にはどのような理由で基底面転位が導入されるのかを、推察、整理し、この連載の(6),(7)で整理します。
(e) そして最後にn–ドリフト層部分に残存、発生、導入されるそれぞれの基底面転位からどのような形状の積層欠陥が生成するのかを、連載(8),(9),(10),(11)で考察します。これらの考察ができれば、積層欠陥の発生源になっている基底面転位が、どのような理由でn–ドリフト層部分に残存、発生、導入されたかが推察されます。これによりデバイスプロセスでの対策を立てたりすることが、可能かもしれません。詳細な話は別に読みたくはない、結論・要点のみを知りたいという人は、この連載の最終部分、連載(8)以降を読んでください。
以下にこの順番に従って解説を進めます。







コメントを残す