4H-SiCのウエハ中には転位が含まれています。結晶成長技術の改良により転位密度は年々低下していますが、現在でもある程度の密度の転位を含んでいます。よく知られているようにSiウエハはほぼ無転位です。この違いにより、SiCウエハはSiウエハとは異なる振る舞いをします。無転位のSiウエハに応力を加えていくと、ウエハは弾性変形しますが、弾性変形の限界に達すると劈開により破壊されてしまいます。Siウエハは弾性変形の範囲であれば元の形状に戻ります。SiCのウエハは硬いので簡単には変形しませんが、高温では転位が動きます。転位が動くとウエハは塑性変形します。塑性変形すると元の形状には戻りません。これがSiCとSiウエハの大きな違いの一つです。
2010年代の初期、SiCウエハの6インチ化の研究が推進されました。6インチ化の研究とともに転位密度を下げる結晶の高品質の結晶成長技術や、ウエハプロセスの洗練化、高速化、低コスト化の技術開発も行われました。これらの技術開発の過程で、SiCウエハの各種の調査、計測が行われています。これらの計測のうちウエハの形状変化が大きな調査テーマの一つになりました。ウエハが塑性変形するとエピ層部に転位が導入されるため、エピ層部に作製されるデバイスに悪い影響を及ぼします。また、変形が大きくなると露光装置が利用できなくなります。ウエハの変形の問題は重要です。特にウエハの口径が大きくなると取り扱いに注意が必要だということが知られています。今回は、2010年代の初期に調査されたウエハの形状の変化について簡単にまとめます。
4H-SiCの単結晶を機械的にスライスしてウエハ形状にすると、切り出すときに端面に近い方向に微妙にカールした形状で切り出されます。変形したということは切断時にそれなりの量の転位を導入したことを意味しています。4H-SiC単結晶中にはもともと転位が導入されており、切断部の温度が局所的に上昇し、また、切断部に応力がかかり、転位が動き、さらに転位が増殖したものと推察されます。切断後、両表面を機械研磨とCMPを行うとスライス時の外形の変形はある程度補正されますが完全に取り除かれるわけではありません。研磨中はウエハ両面は平面ですが、研磨装置からとりはずすと弾性変形し、わずかにカールした形状に復元されます。切断時の形状の変形は研磨作業で完全には回復されません。これらの塑性変形は、4H-SiC中に多量の転位が導入されていることにより発生します。Siウエハーは無転位なので、このような問題はほぼ発生しません。
ウエハをエピタキシー層成長炉に入れ昇温した後降温するとウエハは再びわずかに塑性変形します。特に昇温速度が速いほど塑性変形が大きくなることが知られています。エピ炉中にウエハを配置する際にウエハの裏面はサセプタと小さな面積で接触しています。昇温中には接触部と非接触の周辺部では温度差が生じ熱応力が発生していると考えられています。昇温速度が速いほど昇温時の温度不均一が大きくなり、ウエハに大きな熱応力がかかると推察されています。熱応力によりウエハ内部の転位が動き塑性変形を起こし、わずかに形状が変化します。後のデバイスプロセスに支障がない程度のウエハ変形の範囲になるように、エピ炉での昇温降温速度は設定されています。
エピ層成長中の高温でもウエハの温度の不均一は存在し、ウエハはお椀状に変形していると考えられています。ウエハの中心付近の上面(Si面)はサセプタに接触している部分より温度が低いので結晶格子が収縮し、ウエハの中心付近の下面(C面)のサセプター接触部は結晶格子が膨張しています。この状態を図1に示します。ウエハ中心部のSi面で、収縮したSiCの結晶格子の上にSiCエピ層結晶が成長します。エピ層が成長して厚くなると格子の収縮に耐えることができずに界面転位と名づけられている基底面Cコア刃状転位を整列させて、エピ膜中での格子の収縮を緩和させています。
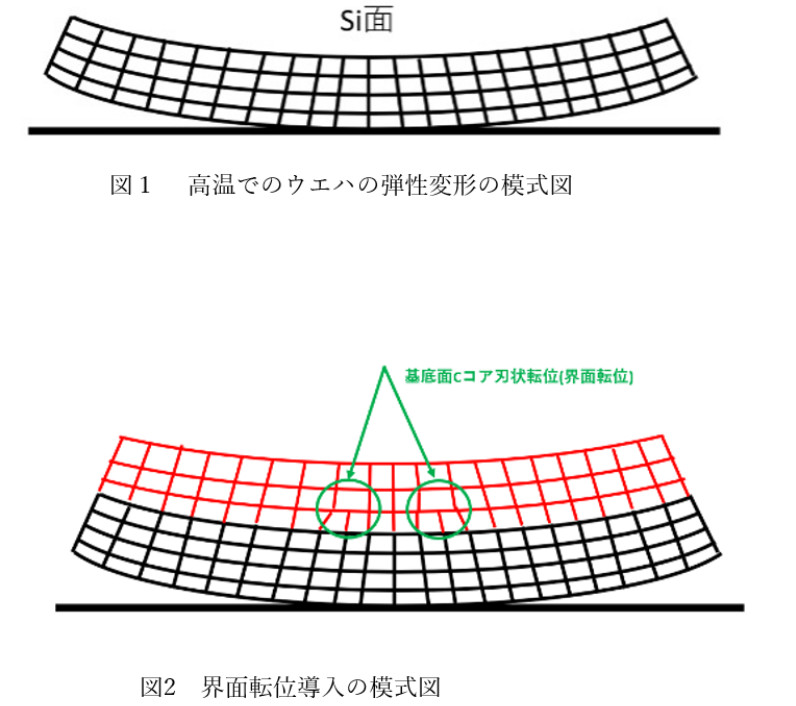
界面転位の導入に関してSiGe系エピタキシー膜で議論された臨界膜厚のコンセプトで考えることはできません。なぜなら、最初から多量の基底面転位が基板のウエハに存在しているので、転位が最初には存在していないSiウエハ上でのSiGeエピ層成長に伴う界面転位導入に関する臨界膜厚とは根本的に話が異なります。SiCのエピ層成長に伴う界面転位の導入に関する議論が盛んにおこなわれていた時に臨界膜厚で考える人たちがいましたがこれは誤りです。SiCのホモエピ成長では界面転位の導入は比較的容易に進行します。またこれらの転位は界面転位と名付けられてはいますが、界面近傍のみに存在しているのではなく、エピ層中のいろいろな深さに分布しています。
エピ層成長中の高温状態では4H-SiCウエハの基板部は図2のように変形しています。エピ層部には界面転位が導入されます。この状態で室温に戻すとほぼこの状態が保存されます。つまりエピ層成長により、ウエハのお椀状の変形は室温でも維持されています。基板のウエハは主に弾性変形をしているので、エピ層を研磨して取り除くと基板ウエハの変形はある程度元の状態に戻ることが知られています。
これらのSiCウエハの変形は、そもそもSi系のエピ成長温度よりもかなり高い温度で行われていることも原因です。エピ炉中でのウエハの温度分布の不均一を小さくする等の工夫により、エピ層中に導入される界面転位は、後のデバイスプロセスで支障を起こさない程度に抑制されています。ウエハの口径が大きな場合やエピ層が厚い場合などは変形の抑制の難易度が上がることが知られています。
これらの成果は次世代パワーエレクトロニクス研究開発機構最終成果報告書に記載されています。この成果報告書はNEDOのページから閲覧可能です。また下記の論文に界面転位の生成のメカニズムについての記述があります。
- X. Zhang et al., Mat. Sci, Forum Vol. 679-680 pp306-309 (2011).






