この連載記事は、半導体中の格子欠陥の解析評価に興味を持つ人を対象に連載記事として書いています。放射光X線トポグラフ法で4H-SiCの格子欠陥がどのように観察されるかについての解説は、今回が最後の連載記事です。前回まで、基底面転位、貫通刃状転位、貫通らせん転位、ショックレー型部分転位、ショックレー型積層欠陥、フランク型部分転位、フランク型積層欠陥のコントラストについて説明しました。今回は、放射光X線トポグラフ法の応用の一例を紹介して、この連載の終わります。この回では、かつて、原因が明確ではなかった4H-SiCのエピウエハ表面に出現する“潜傷”について放射光X線トポグラフ法を用いて解析した例と、これに関連して4H-SiCウエハの表面近傍の浅い位置での転位がどのように観察されるかについて解説します。
潜傷について
4H-SiCのウエハ表面でエピ層成長を行うことが可能なエピレディウエハは、ウエハを供給する会社から購入することができますし、ウエハの表面を精密に研磨する半導体ウエハ研磨会社にお願いして、表面が整っていないウエハを、エピ層成長用に研磨をしてもらうことも可能です。これらのエピレディウエハの表面研磨は、機械研磨の後、化学機械研磨(CMP: Chemo Mechanical Polish)を行います。化学機械研磨を行なった後のウエハの表面を光学顕微鏡で観察すると、とても綺麗に仕上がっていて、表面に凹凸は観察されず、表面形状の異常は観察されません。このCMPプロセス後の表面状態を図10-1(a)に示します。ところが、これらのエピレディウエハにエピ層を成長させると、凹凸のある傷状のパターンがエピ層表面に出現することがあります。この状態を図10-1(b)に示します。このようなエピ層表面の傷状のパターンは、このエピウエハを使って作製するパワーデバイスの歩留まりを大きく落としてしまう原因の一つです。
この現象がどのような原因で発生するのかは2010年代初頭までは不明でした。この原因については、それまではいくつかの議論がなされていました。研磨屋さんたちはエピ層成長技術に問題があると考えたり、ウエハそのものが均質ではなく、サブミクロンサイズの空洞がウエハにはあるからだと、考えたりしていたようです。一方で、エピ屋さんたちは研磨技術に何らかの問題があるのではと考えていたようです。
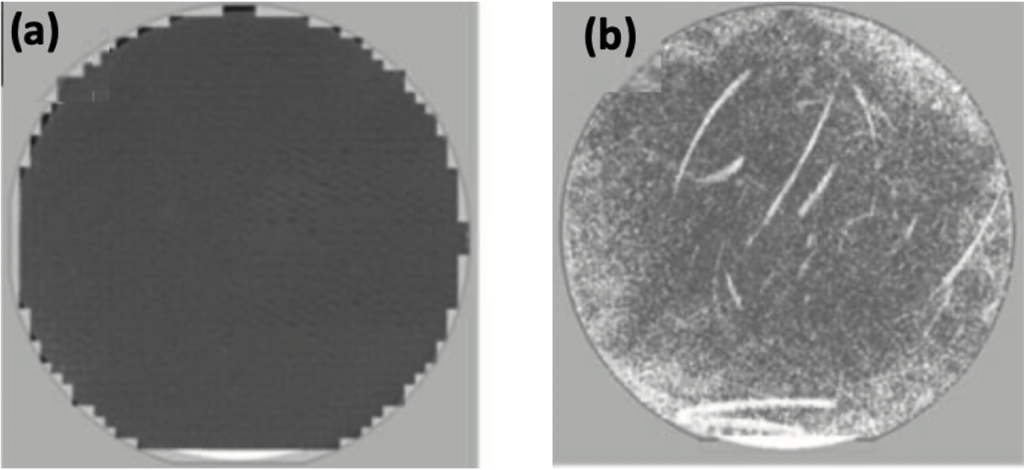
4H-SiCのエピ層成長を行うには、エピ層成長炉中で、まず高温でH2ガスを流しウエハ表面のクリーニングを行います。この段階で温度を下げてSiCのウエハをエピ層成長炉から取り出し、その表面を光学顕微鏡で観察すると、すでに傷状のパターンがウエハ表面に出現していることがわかりました。ここから推察されることは、ウエハ表面直下に局所的に格子欠陥密度の高い場所が存在していて、H2ガスによって表面直下の局所高密度格子欠陥部がエッチングされて表面に凹凸が発生するのではないかというシナリオです。
エピ層成長の最初に表面凹凸が局所的に発生すると、エピ層成長時に凹凸部の面積や凹凸の高さが増大することも観察されました。この現象の発生源を日本では潜傷と呼んだりしています。H2エッチング後にスクラッチ状のものが光学顕微鏡で観察される場所をSEM像を図10-2に示します。表面の形状が荒れていることが観察されます。
エピレディ状態のウエハの表面をベルク・バレット放射光X線トポグラフ法で観察すると、各種転位などと共に、スクラッチ状で、なおかつ細くて淡いコントラストものが観察されることがあります。この一例を図10-3に示します。赤い矢印のスクラッチ状のものは、白い矢印で示す1本の基底面転位のコントラストよりも細く、弱いコントラストを示しています。このようなコントラストが観察されるウエハの表面にエピ層を成長させ、再び放射光X線トポグラフ法で観察すると、このスクラッチ状の細くて淡いコントラストは消えています。しかしながら、スクラッチ状の淡いコントラストが観察された場所には、図10-1(b)で示すようなスクラッチ状の表面凹凸が発生しています。エピ層成長後に淡いコントラストが消失するのは、H2エッチングによって薄いコントラストを発生させる表面直下の格子欠陥が取り除かれていると考えられます。
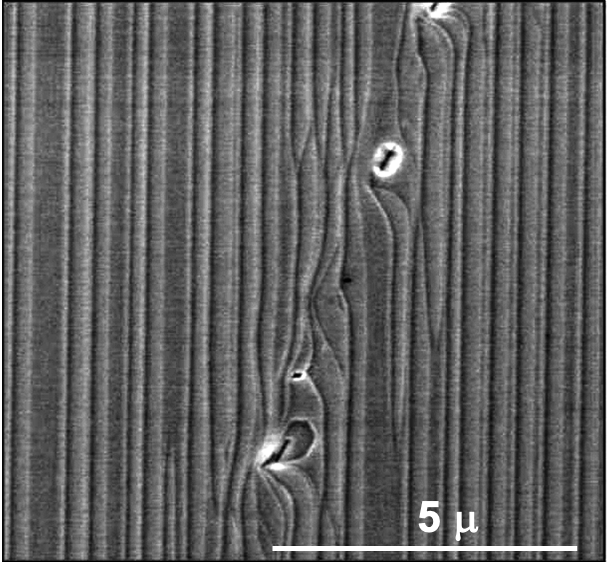








コメントを残す