以前、エピレディウエハの表面を軽くCMPをする。→放射光トポグラフ法で観察する。→軽くCMPをする。→放射光トポグラフ法で観察する。→軽くCMPをする。→放射光トポグラフ法で観察する、を繰り返す実験を行なっています。これを繰り返すと、トポグラフ像上では、ウエハのいろいろな場所で、細くて淡いスクラッチ状コントラストが発生したり、消失したりすることが観察されました。このことより、この表面直下にあると考えられる欠陥はCMPで導入され、CMPで削り取られていくことが推察されました。
放射光トポグラフ像で細くて淡いコントラストのスクラッチ状のものが観察される位置を光学顕微鏡で観察しても特別変わったものは観察されず、CMP仕上げの美しい表面が観察されます。しかしながら、この位置の表面を、SEMあるはAFMで観察すると、幅や深さが数十ナノ程度から数ナノ程度のスクラッチが観察できます。場合によっては1ナノ程度のもので、スクラッチが存在しているのか、していないのか、表面形状からは不明な場合もあります。放射光トポグラフ像は、原子核乾板や、X線フィルムで撮影し、それを光学顕微鏡で撮影しています。放射光トポグラフ像の分解能は光学顕微鏡の分解能のミクロンオーダー程度です。トポグラフ像で観察された、細くて淡いコントラストのスクラッチ状のものは、ナノメーターレベルの表面スクラッチの下にミクロンレベルで広がる高密度の転位組織が原因の歪みによるコントラストではないかと考えられます。
潜傷検出の方法
潜傷の研究が注目されていた2010年代前半に、関係した研究者が潜傷の検出を色々と試みていました。これらの研究者の多数は、表面形状に着目して検出を試みることを行いましたが、表面形状の観察の場合2つ問題があるように思います。この現象の原因となるスクラッチはナノメーターレベルなので、SEMかAFMで検出しようとすると、直径数インチのウエハの表面全体を端から端までナノメーターレベルで注意深く観察しますか?という課題が1つにはあります。なぜか、そういう根性と忍耐を伴う仕事をやりたがる人はいます。もう一つの問題は、幅と深さが数ナノメートル程度のスクラッチになると、スクラッチが存在しているのかそうでないかも、SEM像やAFM像でも曖昧で判断できないということです。問題を引き起こしているのは表面の形態というより、表面直下に広がる高密度の格子欠陥だと考えられます。潜傷を検出するには、放射光トポグラフ法を用いると簡単ですが、研磨屋さんたちは、わざわざ放射光など、そんなものは使わないよという考えです。お馴染みのKOHエッチングでも検出でるのではと思います。
潜傷の転位組織
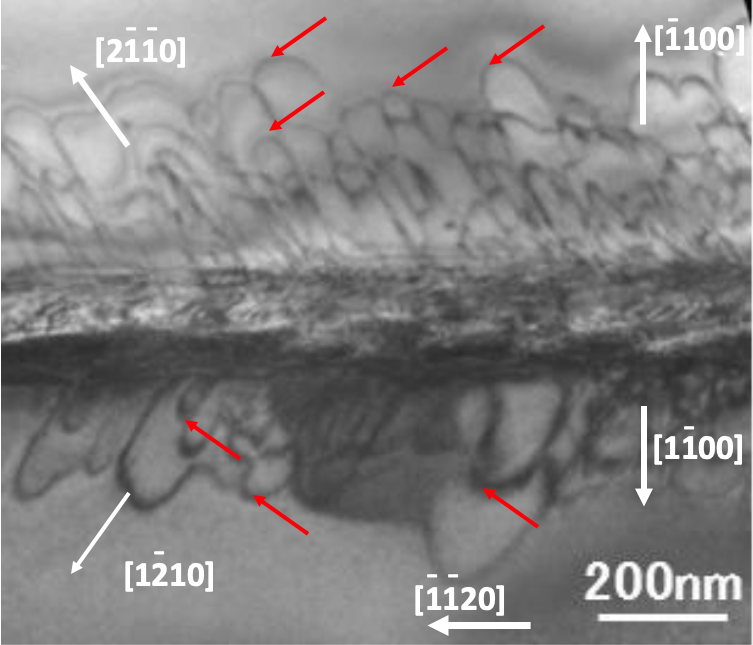
図10-3で観察される細くて淡いスクラッチ状コントラストが観察されるような場所をFIBで切り出し平面観察用試料を作製し透過型電子顕微鏡で観察した明視野像の例を図10-4に示します。観察方向は[0001]方向からです。図の水平方向に伝搬するスクラッチから多量の基底面転位が湧き出ています。g・b解析を行い、本連載の(2)で説明した転位の向きを設定するやり方で転位の向きを設定して、バーガース・ベクトルを求めると、図10-4のスクラッチの上側の転位のバーガース・ベクトルは、基底面完全転位のb=1/3[2110], スクラッチの下側の[1100]側のバーガース・ベクトルはb=1/3[1210]だと求められます。バーガースベクトルと平行か反平行な部分の転位は基底面らせん転位部です。いくつかの赤い矢印で示した、張り出している基底面転位ループの先端部分は基底面Siコア刃状転位部です。基底面Cコア刃状転位部が張り出した部分は観察されません。本連載の(2)で説明した転位の方向を設定するやり方を用いてバーガース・ベクトルを求めた場合、表面側の結晶は バーガース・ベクトルと同じ方向、[2110]方向か[1210]方向に塑性変形しています。つまり、このナノスクラッチは、硬いものがCMP中にSiCウエハ表面に食い込んで、さらに右から左方向 [1120]方向へ移動して擦って発生したものだということが理解できます。
図10-4を見て大きな疑問が出てくると思います。このナノスクラッチ部では基底面転位が湧き出した高密度転位部なのに、なぜ図10-3の放射光トポグラフ像では、1本の基底面転位より、細くて淡いコントラストを示すのか?ということです。このようなナノスクラッチ部分の断面観察試料をFIBで作製して透過型電子顕微鏡で観察すると、ナノスクラッチ部の基底面転位の大部分はウエハ表面から数10ナノメートル以内のところに存在しています。表面の効果により、転位の周囲の格子歪みはかなり緩和され、X線回折によって格子歪を伴っていると見なされる部分の体積が小さいので、深い場所にある各種転位と比べて弱く細いコントラストを示しているのではと推察しています。
エピ層表面凹凸のメカニズム

図10-5にエピ層表面凹凸のメカニズムを模式的に示します。図10-5(a)はCMP中に何らかの小さなスクラッチが偶発的に導入され、そのスクラッチの周囲、表面直下に基底面転位、積層欠陥などの格子欠陥をばら撒きます。これらはCMPに導入されているのでCMPにより表面スクラッチは削られ、幅と深さは数10-あるいは数ナノメーターのスクラッチ、あるいは表面からは消失した状態になります。しかし表面直下にたくさんの転位が残っています。この状態を図10-5(b)に示します。次にエピ層成長炉に入れ、高音でH2クリンーニングを行うと、表面直下の転位はエッチングによりとりさられますが、表面凹凸が形成されます。この状態を図10-5(c)に示します。そののちエピ層成長を行うと、表面凹凸を起点として高いステップを伴うステップバンチングが広範囲に広がります。この状態を図10-5(c)に示します。







コメントを残す