1-1. はじめに
半導体プロセスの研究開発の過程で、透過型電子顕微鏡観察を必要とすることがあります。よくある利用目的は、新しく開発した半導体のプロセス、つまりウエハのプロセスや、デバイスのプロセスで、転位などの格子欠陥を新たに生成していないか、格子欠陥が残留していないか、あるいは動作不良の原因に格子欠陥が関係していないか、狙った構造が問題なく形成されているかの確認などです。そして、企業での研究開発の場合は、半導体プロセスの研究者は、企業内の分析部門や、あるいは企業外の別の会社や、外部の組織などの電子顕微鏡担当者に観察を依頼します。
透過型電子顕微鏡を用いた転位や積層欠陥などの有無の確認に最も簡単で有効な観察方法は、g・b解析法やg・R解析法と呼ばれている手法です。g・b解析法、g・R解析法は、転位のバーガース・ベクトルや積層欠陥の変位ベクトルを解析するための手法ですが、この手法は、広い視野で転位や積層欠陥などの有無を容易に確認することができます。SiCパワー半導体研究者が透過型電子顕微鏡観察を依頼する場合、目的が、転位や積層欠陥の有無の確認の場合、この手法で、まずは観察することになると思います。
g・b解析法、g・R解析法に関しては日本語の本としては、坂公恭著「結晶電子顕微鏡学」に簡潔明瞭に紹介されています。しかしながら、この本では主にFCC構造の結晶の格子欠陥の観察を中心に書かれていて、これを読んで、いきなり六方晶構造の4H-SiCの格子欠陥の透過型電子顕微鏡観察の仕様をどうするかを考えると、困難に遭遇するようです。
そして、SiCパワー半導体研究者と電子顕微鏡担当者との間で、g・b解析法、g・R解析法を使った観察仕様についての円滑なコミュニケーションの達成が重要なことになります。きちんとした観察の仕様を透過型電子顕微鏡担当者に伝えなければ、必要な結論は得られ難いことになります。
この一連の連載の文章は、g・b解析法を用いて透過型電子顕微鏡観察を、外部に依頼する際に、パワー半導体研究者が、どのように観察の仕様を示すべきかを、g・b解析法の原理に基づいて考察し、マニュアル的に示します。この連載の文章は透過型電子顕微鏡の具体的操作についても記述していますが、その部分については、パワー半導体研究者は理解する必要はありません
一方で、透過型電子顕微鏡担当者が、実際の観察作業を問題なく実行できるように、具体的な観察作業の詳細な内容をマニュアル的に示します。また、透過型電子顕微鏡担当者は、g・b解析法の原理、観察のマニュアル的内容も理解していただければと思います。
SiCパワー半導体の研究開発を行っている企業で、自社内に分析部門を持ち、自社内の透過型電子顕微鏡による観察作業を行っているような場合も、本連載の説明文は、SiCパワー半導体研究者が、透過型電子顕微鏡担当者と円滑なコミュニケーションをとることに役立つような内容を目指します。
この連載では、g・b解析法の原理を最初に説明します。この話は以前の連載解説文、”放射光トポグラフ法の利用(4)“と同じ話です。ここで新たに書く必要もないかも知れません。しかしながら、放射光の過去記事を読んだ後に、いきなり透過型電子顕微鏡でのg・b解析法の具体的なやり方を考えるのも、難しい話かも知れません。そこで、g・b解析法について、簡単に要点を最初に復習することにしました。
このような回折現象を利用する場合、どのような反射を選んで観察すべきかは、重要な課題です。4H-SiCの逆格子空間で逆格子点の配置も必要な知識です。4H-SiCの逆格子空間の構造についても連載(1)で少し説明します。この内容は既に、“4H-SiCの積層欠陥欠陥について(4)”で既に紹介しています。今回、透過型電子顕微鏡活用を目的として簡単に復習します。SiCの転位や積層欠陥を、g・b解析法で観察するやり方は既に知っているよ!という方はこの連載の文章を読む必要はありません。
パワー半導体研究者が透過型電子顕微鏡観察を必要とする目的は、格子欠陥の観察ではない場合もあります。例えばヘテロ界面の観察、各種のプロセスが狙い通りに行われているのかの確認などです。それらの観察目的ではg・b解析法以外の手法も使います。高い分解能での像観察、EDSによる分析、などの手法を使います。これらの観察手法は、電子顕微鏡観察の共通的な基本技術です。透過型電子顕微鏡担当者は既に熟知しているので、これらの手法については、この連載では取り扱いません。
1-2. 回折現象と転位の歪コントラスト
g・b解析法は回折現象を利用して、転位の歪によって発生するコントラストを観察する手法です。図1-1 (a)は電子顕微鏡を使って試料を観察する際の回折現象を模式的に表しています。波数ベクトルk0の入射電子が面間隔dの結晶面で回折を起こし反射波kgが生成しています。この時には、おなじみのブラッグ条件、2dsinθ=nλが成立しています。θはブラッグ角です。図1-1 (b)はこの時のブラッグ条件を逆格子空間で表現しています。回折を起こしている逆格子ベクトルgは、図1-1 (a)に示している回折を起こしている結晶面に対して垂直方向を向いています。そして逆格子ベクトルgはブラッグ条件を満たしている時はエバルト球と接触しています。

電子は、観察試料のある程度の広い領域に均一の強度でシャワーのようにふりそそがれています。入射電子ビームが均一の強度でふりそそがれていて、結晶の各位置で回折を起こしている場合、観察される回折波の強度も、場所場所で均一です。
図1-2(a)は結晶中に基底面刃状転位が存在している状態です。転位の周囲には格子歪が発生しています。図1-2(a)の緑色のAの領域は歪が無い時の結晶面間隔dより収縮しています。また緑色のBの領域は結晶面間隔dより拡大しています。転位の周りの歪場の領域では面間隔はdから外れてしまうので、ブラッグ条件2dsinθ=nλからは外れてしまい転位の周りの歪場の存在により回折波の強度に変化が生じます。つまり回折波を取り出して拡大した像を見ると転位の周りにコントラストが生じています。この歪場によって生成されたコントラストの幅は数十ナノメーター程度の幅があるので、透過型電子顕微鏡観察では数万倍程度の倍率で十分転位の存在を確認することができます。これくらいの倍率だと比較的大きな視野を観察することができます。
試料中で電子線の非弾性散乱の効果がないと仮定すると、図1-2(b)に示しているように、回折電子と透過電子の和の強度は入射電子の強度と同じです。入射電子の強度が均一だとすると、回折波による像で転位の位置でコントラストが生じているとすると、透過電子を選んで拡大して見ると、転位の歪よるコントラストが観察されます。
透過波を選んで観察する像を明視野像、回折波を選ん観察する像を暗視野像と読んでいます。明視野像と暗視野像のコントラストは非弾性散乱の効果を無視すると相補的に現れることになります。つまり明視野で明るいコントラストの位置は暗視野像で暗いコントラストを示すことになります。実際には試料との相互作用による電子の非弾性散乱の効果により、相補的なコントラストから外れていますが、ここでは簡単に、そのように説明しておきます。
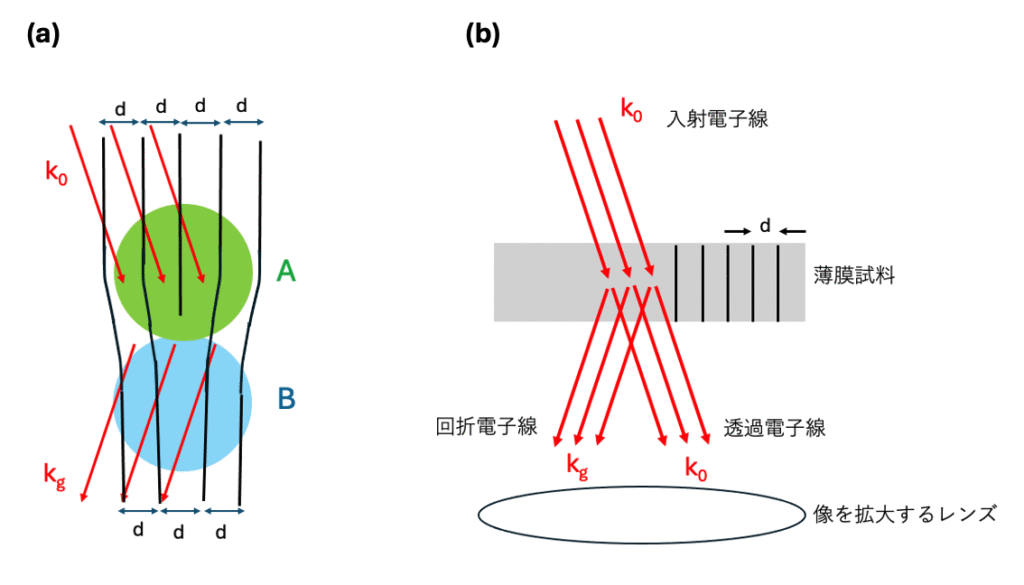
図1-2 (a)では転位の周りの格子歪によって回折波のコントラストが発生することを説明していますが、それではどんな格子歪がコントラスト変化を発生させるのかを考えてみます。図1-3 (a)は回折を起こしている結晶面に対して面間隔方向に格子歪が発生している状態を示します。図1-3 (b)は回折を起こしている結晶面に平行方向に格子歪が発生している状態を模式的に示しています。図1-3 (a)の場合は、暗視像や明視野像にコントラスト変化を発生させます。図1-3 (b)の場合は、格子歪が発生しているのもかかわらず、この回折の状態ではこの格子歪を検出することはできません。
回折を起こしている結晶面に垂直な方向は図1-1(b)のgベクトルで表現されています。格子歪の方向をΔdベクトルと示すと、gとΔdの内積の値が0の場合は、暗視野像や明視野像では格子歪のコントラストは発生しません。図1-3(b)に示すように、ΔLとgが直交している場合は、コントラストは発生しません。gとΔdの内積が0ではない時には暗視野像や明視野像では格子歪によるコントラストは発生すると、定性的には理解されます。







