この連載を掲載してから4年が過ぎた。連載のきっかけになった 応用物理 2021年5月号の解説記事を執筆した東脇正高さんが、IEEE Electron Device Magazine 2024年12月号に最新のレビューを書いている。東脇さんの2021年と2024年のレビューを比較しながら、酸化ガリウム (Ga2O3) パワーデバイス研究の進展と、他のワイドバンドギャップパワー半導体の進展も踏まえて、Ga2O3パワーデバイスの有望な適用分野を考えてみたい。
2024年版でGa2O3の物性データのアップデートは無かった。最も興味がある絶縁破壊電界は、耐圧試験で破壊したGa2O3デバイスに印加した最大電圧から見積った電界強度のままだった。進展がみられたのは、p-NiOx/n-Ga2O3 pnダイオードでアバランシェ降伏(非破壊)が観測されたことだ。これで非破壊の絶縁破壊電界を測定できるはずだが、実際に測定した報告はまだない。再現性のあるアバランシェ降伏の確認は一歩前進だが、連載(2)で触れたようにp-NiOxとn-Ga2O3 のどちら側でアバランシェ降伏が起きたか、注意深く測定データをみる必要があるだろう。
デバイス開発では、SBDの端部終端構造に進展があった。終端構造のフィールドプレートにチタン酸バリウム (BaTiO3) などの高誘電率材料を導入し、絶縁体内の電界を小さくしてSBDの耐圧が上がった。この原理を脚注1 で詳しく解説したが、これでp型問題が解決するとは言えない。
この4年間の研究開発で、Ga2O3縦型ダイオードのオン抵抗と耐圧のベンチマーク(図5-1)上に、低抵抗で高耐圧(右下)の点が増えたのは頼もしい。ただし2024年時点でまだSiCの理論限界を凌駕した報告はない。
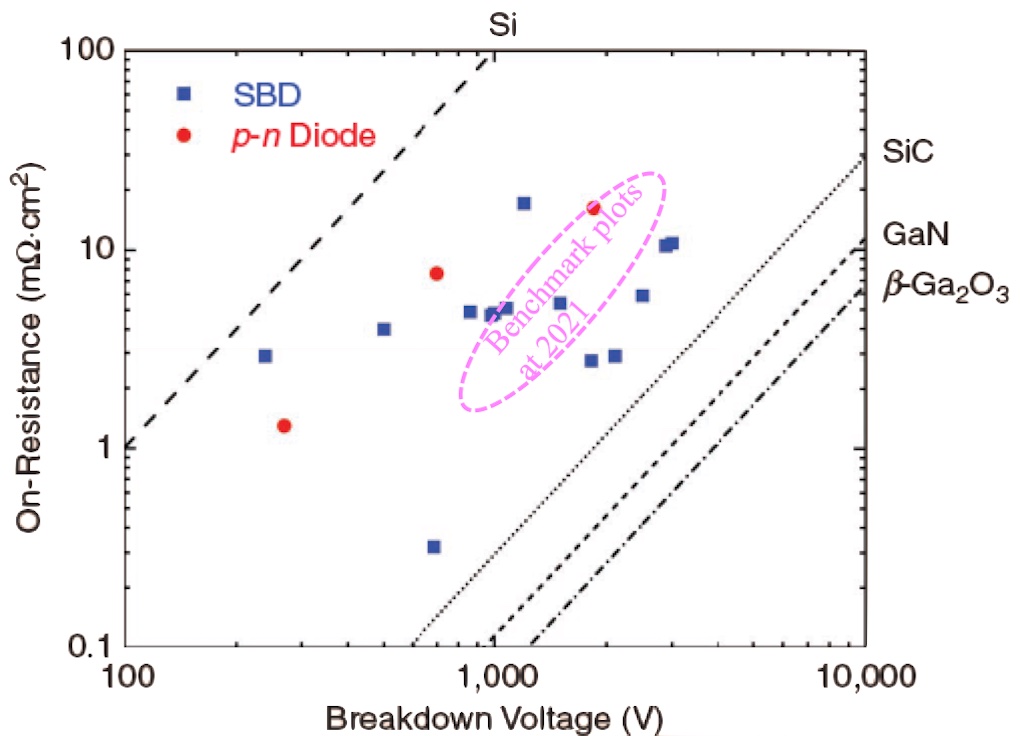
MOSFETについては、p型のGa2O3ができない中、さまざまな工夫を行なって試作されている。ひとつは、Double-implanted MOSFET (DMOS) である。Nイオン注入で形成した高抵抗Ga2O3層とゲート絶縁膜の界面に反転チャネルを誘起する。深いアクセプタ順位にホールがトラップされて空乏層が動かない高抵抗層とは言え、初のEnhacement型である。Depletion型では、n型Ga2O3の表面に形成した薄い塀状の導電チャネルを、ゲート絶縁膜を介して空乏させる、縦伝導のFinFETが試作されている。オン抵抗と耐圧のベンチマークは、SBD同様、SiCの理論限界を越えるものはない。
2025年春の応物学会で、ノベルクリスタルテクノロジーから耐圧 5.15 kV でSiC限界に近い好特性のFinFETが報告された (15a-K403-9)。耐圧を超えるとFin底部が破壊する。発表にあったGa2O3最大電界強度 3.72 MV/cm2 から、Fin底の酸化膜電界強度を見積ってみると 10 kV/cm 程度になり、酸化膜が絶縁破壊したことがわかる。MIS構造で最大電界を支える限り、耐圧がGa2O3ではなく酸化膜の絶縁破壊で律せられている点は変わらない。
このようにこの4年間にいくつか進展があったが、なかなかGa2O3の理論限界に迫るデバイス特性が得られていない。やはり、p型Ga2O3ができないことが障害になっている。実用化が進むSiCの理論限界を越える特性が示されないと、パワー半導体メーカーが本格的にGa2O3に参入するのは厳しい。2024年のレビューは、”The next decade will determine whether Ga2O3 will end up being just a trendy material or reach practical device application and industrialization.” と結ばれている。Ga2O3の正念場である。
次のページでGa2O3パワー半導体の有望な用途を考える。
脚注1 連載(4)で解説したように、絶縁体の誘電率が小さいとGa2O3が絶縁破壊するよりも先に絶縁体が絶縁破壊してしまう。 SiO2(比誘電率 3.9)とAl2O3(比誘電率 9)を例に挙げたが、BaTiO3の比誘電率は遥かに大きい4500もあり、BaTiO3内部の電界強度はGa2O3の 1/400になる。p型が無くともMIS構造で問題解決!と思うが、そうは問屋が卸さない。酸化物は誘電率が大きいとバンドギャップが小さい傾向があり、BaTiO3のバンドギャップは 3.2 eV でGa2O3よりも小さい。金属/BaTiO3/Ga2O3 MIS構造に逆バイアスをかけたときのエネルギバンド模式図を図5-fn (a)に示す(BaTiO3とGa2O3はType1のヘテロ接合と仮定)。バンドの傾きが電界強度に相当し、BaTiO3中の電界がGa2O3中よりもずっと小さいイメージが理解できるだろう。電極とBaTiO3の間にはショットキー障壁があり、BaTiO3中の電界強度が小さいのでFNトンネル電流も流れず、電子電流は問題にならない。Ga2O3の価電子帯には自由正孔がいないので正孔電流も漏れない。ここまではOK。ただし、Ga2O3がアバランシェ降伏を起こすと(赤色)発生した正孔が金属電極へ流れ込み、その発熱で絶縁膜を破壊してしまう。それなら、図5-fn (b)のように、BaTiO3とGa2O3の間にSiO2を挟めば、伝導帯と価電子帯どちらにもエネルギ障壁ができて一見良さそうだ。Ga2O3がアバランシェ降伏を起こすような電界が加われば、真っ先にSiO2が絶縁破壊してしまい結局SiO2無しと同じ。MIS構造では、Ga2O3のアバランシェ降伏、即、SBD破壊故障となる。実回路動作下でGa2O3がアバランシェ降伏しないよう設計電界強度に十分な余裕を持たせないとならない。
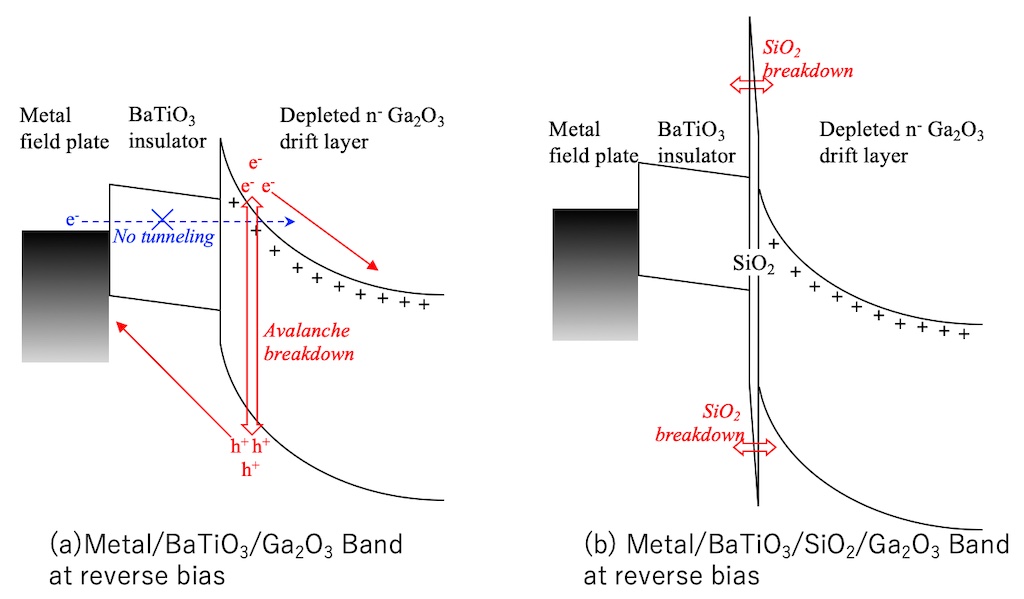







コメントを残す